一周资讯速览:SORA开放!半导体行业新突破。


概要
本周,科技领域迎来了几项重大进展:OpenAI发布了革新性的AI视频生成工具Sora及其加速版本Sora Turbo,开启了视频创作的新纪元;苹果与博通携手,计划于2026年推出专为服务器设计的AI芯片Baltra,旨在强化云端AI任务处理能力;三星遭遇HBM3E内存技术挑战,供货推迟至2025年,而在高带宽内存领域的竞争中暂时落后于SK海力士;博通推出了创新的3.5D F2F封装技术,为AI加速器的发展提供了新动力;Intel在IEDM 2024上展示了多项代工技术突破,包括显著提升吞吐量和互连效率的新材料和技术,为AI应用的未来奠定了坚实基础。这些发展标志着AI与半导体技术的进步正以前所未有的速度推进。
本周的科技资讯速览将带您深入了解这些重要进展及其对行业的影响。
OpenAI 推出 Sora:AI 视频生成新时代
首次发布即引起轰动的SORA在十个月后终于姗姗来迟。
OpenAI 正式发布了其全新的 AI 视频生成工具 Sora,以及更快速的 Sora Turbo 版本。用户现在可以根据文本提示轻松创建逼真视频,最长可达20秒,并能探索多种变化。
Sora 不仅能处理风景镜头达到专业级质量,还提供了编辑功能如替换、删除或添加元素,重新剪辑和合并视频。它支持从480p到1080p的各种分辨率,满足不同需求。

苹果联手博通开发AI芯片,预计2026年推出
据The Information报道,苹果与博通正合作开发一款专为服务器设计的AI芯片,代号Baltra,预计最早2026年亮相。这款芯片旨在满足云端处理复杂AI任务的需求。
苹果三年前启动了这项计划,目标是通过自家芯片在云端处理AI任务。其策略分为两层:
设备端处理:简单AI任务(如短信摘要)由设备内部芯片完成。
云端处理:复杂任务(如图像生成或长篇邮件回复)则转移至高性能AI服务器处理。
苹果知名爆料人马克?古尔曼指出,尽管设备端AI功能仍至关重要,但新功能的实现需要更强大、高效的芯片支持。此次合作表明苹果致力于提升AI处理能力,使Apple Intelligence更加智能和高效。
苹果CEO库克曾表示,AI是科技巨头竞争的核心领域之一,苹果的优势将助力公司在这一新时代中脱颖而出。
简而言之,苹果与博通的合作标志着AI技术发展的又一重要里程碑,预示着未来AI任务处理将更为复杂和强大。

三星HBM3E内存供货推迟
据韩媒报道,三星的HBM3E内存未能达到英伟达的要求,年内供货无望,预计推迟到2025年。自2023年10月起提供测试样品后,认证进展缓慢,主要因为发热和功耗问题未达标。
SK海力士在HBM3E技术上的领先,设定了行业标准,其采用的MR-RUF键合技术优于三星的TC-NCF技术。这使得SK海力士在性能上占据优势。
尽管三星在全球HBM市场曾是领导者,但在HBM3E竞争中暂时落后。三星计划2025年第一季度开始向英伟达等客户供货,并希望通过未来的HBM4工艺重新获得竞争力。
简而言之,三星HBM3E未能按时通过英伟达认证,显示其在高带宽内存领域暂时落后,但正积极准备未来反击。

博通推出业界首个3.5D F2F封装技术
博通宣布推出3.5D eXtreme Dimension系统级(XDSiP)封装平台,成为业界首个3.5D F2F(Face2Face)封装技术。这项新技术结合了2.5D和3D-IC集成的优点,支持开发下一代AI加速器和计算ASIC。
亮点:
信号密度:相比F2B技术,信号密度提升7倍。
能效:采用3D HCB技术,功耗降至原来的十分之一。
低延迟:减少计算、内存和I/O组件间的延迟。
成本与翘曲改善:支持更小的转接板和封装尺寸,降低成本并改善封装翘曲问题。
博通正在开发6款基于此平台的产品,预计2026年2月开始出货。这一创新标志着自定义计算的新时代,为大规模AI应用提供了先进且优化的SiP解决方案。
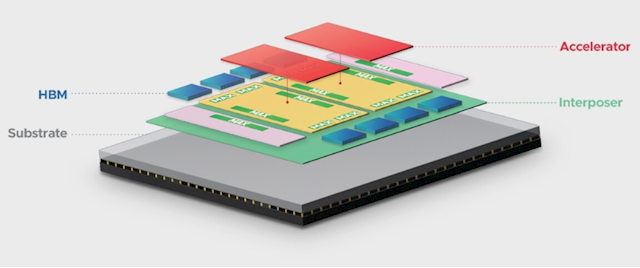
Intel 展示多项代工技术突破:吞吐量提升100倍
在IEDM 2024上,Intel展示了多项技术突破,重点包括:
钌互连技术:减成法钌互连可将线间电容降低25%,改善芯片内互连效率。
异构集成解决方案:新封装技术使芯片间封装吞吐量提升至100倍,大幅加快数据传输速度。
RibbionFET CMOS 和 2D FETs:展示硅基RibbionFET CMOS技术和2D场效应晶体管的栅氧化层模块,以增强微缩和性能。
GaN 技术进展:推进300毫米GaN技术,制造高性能微缩增强型GaN MOSHEMT,减少信号损失并提高线性度。
Intel还强调了未来AI发展的三个关键创新方向:
先进内存集成:解决容量、带宽和延迟瓶颈。
混合键合互连:优化互连带宽。
模块化系统连接:提供灵活高效的系统解决方案。
简而言之,Intel通过新材料和技术大幅提升了芯片性能和互连效率,为未来的AI应用铺平了道路。
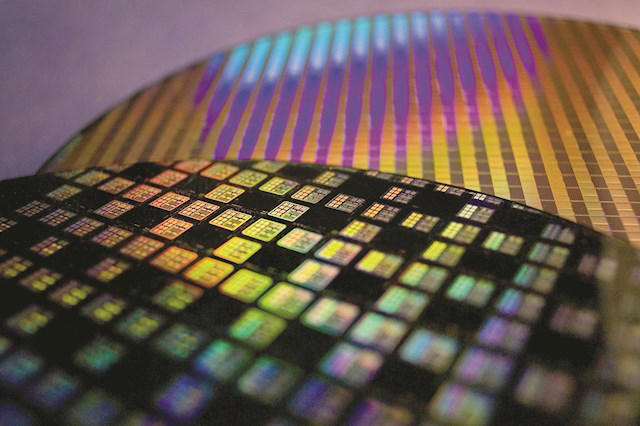
如有任何问题、反馈或合作意向,请直接点击下方按钮。我们期待与您建立联系,共创美好未来。